近日,大日本印刷(DNP)公司宣布了一項重要技術(shù)突破,成功在其生產(chǎn)的光掩模上繪制出支持2納米及以下極紫外(EUV)工藝的精細圖案。這一成果標志著DNP在半導體制造領(lǐng)域的技術(shù)實力達到了新的高度。
據(jù)悉,DNP在本月早些時候正式對外公布了這一消息。在現(xiàn)代光刻工藝中,光掩模扮演著至關(guān)重要的角色,它是將設(shè)計好的電路圖案轉(zhuǎn)移到晶圓上的關(guān)鍵工具。此次DNP所繪制的精細圖案,不僅在線條尺寸上實現(xiàn)了顯著縮小,還在復雜度更高的曲線圖案上實現(xiàn)了同比例的尺寸壓縮,這為生產(chǎn)更高效、更先進的邏輯芯片提供了有力支持。
DNP的光掩模技術(shù)進展并非一蹴而就。早在2023年,該公司就已經(jīng)成功開發(fā)出了適用于3納米工藝的光掩模。而此次為了滿足2納米及以下工藝的需求,DNP在技術(shù)上進行了全面升級,不僅在直線圖案尺寸上較3納米世代產(chǎn)品縮小了20%,還在曲線圖案的復雜度上實現(xiàn)了更高的技術(shù)要求。
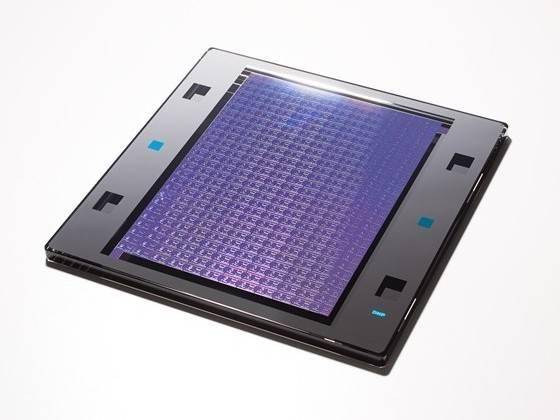
通過對比圖可以看出,DNP此次繪制的精細圖案在直線和曲線方面都展現(xiàn)了極高的精度。直線的邊緣更加平滑,曲線的輪廓也更加清晰,這為后續(xù)的曝光和芯片制造提供了更加可靠的保障。
DNP表示,此次成功繪制精細圖案,意味著其光掩模產(chǎn)品已經(jīng)滿足了2納米及以下名義制程邏輯半導體的生產(chǎn)需求。這一成果不僅為DNP在半導體制造領(lǐng)域樹立了新的里程碑,也為全球半導體產(chǎn)業(yè)的發(fā)展注入了新的動力。
DNP還完成了支持High NA EUV光刻的光掩模的初步評估,并已向生態(tài)合作伙伴出樣。這一舉措將進一步推動High NA EUV光刻技術(shù)的發(fā)展,為半導體產(chǎn)業(yè)帶來更加先進的制造技術(shù)和更高的生產(chǎn)效率。
DNP還透露了其未來的量產(chǎn)計劃。該公司計劃于2027財年(起始于同自然年4月)實現(xiàn)2納米光掩模的量產(chǎn)。考慮到DNP與Rapidus的合作關(guān)系,這一新品預計將用于Rapidus計劃于2025年4月啟動的2納米試產(chǎn)線。這一合作將進一步鞏固DNP在半導體制造領(lǐng)域的領(lǐng)先地位,并為全球半導體產(chǎn)業(yè)的發(fā)展做出更大的貢獻。






















